原子层沉积
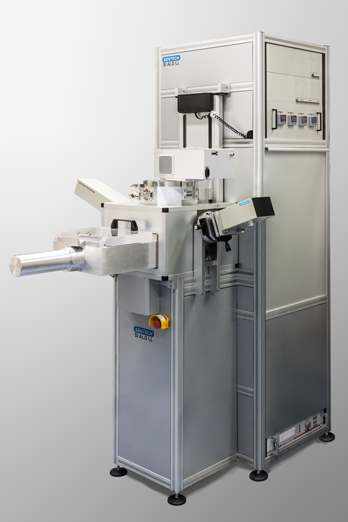
SENTECH ALD设备的优势
用于敏感衬底的PEALD
真远程等离子体源能够在低温<100°C下高均匀度和高保形性地覆盖敏感衬底和膜层,在样品表面提供高通量的反应性气体,而不受紫外线辐射或离子轰击。
用于工艺研发和改善的实时监测
ALD实时监视仪RTM的原位诊断实现了单一ALD循环的超高分辨率。优点是确认ALD范围,减少处理时间和总生产成本。采用椭偏光谱、QCM和QMS进行原位诊断,也是我们原子层沉积设备的优点。
简易的腔体清洗
定期反应腔体清洗对于稳定和可重复的原子层沉积工艺是必不可少的。借助于用于清洗原子层沉积系统的升降装置,可以容易地打开反应腔体。
集成手套箱
SENTECH原子层沉积设备与各种供应商的手套箱兼容。
多腔集成
原子层沉积设备可作为SENTECH多腔系统的一个模块。我们的原子层沉积设备可以与SENTECH PECVD和蚀刻设备结合用于工业应用。可选的多腔系统也具备片盒到片盒装片的特点。
SENTECH原子层沉积设备实现了热ALD和等离子体增强ALD操作。ALD设备可以配置为用于氧化物、氮化物和金属沉积。三维结构具有出色的均匀性和保行性。利用ALD、PECVD和ICPECVD,SENTECH提供等离子体沉积技术,用于从纳米尺度沉积到数微米的薄膜沉积。
SENTECH ALD设备实现了热ALD和等离子体增强ALD膜交替沉积多层结构。热ALD和等离子体增强ALD可在同一个反应腔体中用快门来切换。
SENTECH提供了前沿的快速原位监测技术,实时监测和广泛范围的光谱椭偏仪可逐层监测薄膜生长。

特点:
- 预真空室
- 可选真远程等离子体源
- 低温等离子体增强ALD
- 可用于开腔的升降装置

特点:
- 手动置片
- 可选真远程等离子体源
- 低温等离子体增强ALD
- 可用于开腔的升降装置

特点:
- 用于预真空室和手动置片设备
- 各种供应商的手套箱兼容

特点:
- 3到6端口多腔系统的ALD模块
- 结合PECVD, ICPECVD和等离子刻蚀设备
- 片盒到片盒装片
- 工业应用,高产量